IGBT-транзисторы – основные компоненты современной силовой электроники
IGBT-транзистор (сокращение от англоязычного Insulated-gate bipolar transistor) или биполярный транзистор с изолированным затвором (сокращенно БТИЗ) — представляет собой полупроводниковый прибор с тремя выводами, сочетающий внутри одного корпуса силовой биполярный транзистор и управляющий им полевой транзистор.
IGBT-транзисторы являются на сегодняшний день основными компонентами силовой электроники (мощные инверторы, импульсные блоки питания, частотные преобразователи и т.д.), где они выполняют функцию мощных электронных ключей, коммутирующих токи на частотах измеряемых десятками и сотнями килогерц. Транзисторы данного типа выпускаются как в виде отдельных компонентов, так и в виде специализированных силовых модулей (сборок) для управления трехфазными цепями.

То что IGBT-транзистор включает в себя транзисторы сразу двух типов (включенных по каскадной схеме), позволяет объединить достоинства двух технологий внутри одного полупроводникового прибора.
Биполярный транзистор в качестве силового позволяет получить большее рабочее напряжение, при этом сопротивление канала в открытом состоянии оказывается пропорционально току в первой степени, а не квадрату тока как у обычных полевых транзисторов. А то что в качестве управляющего транзистора используется именно полевой транзистор — сводит затраты мощности на управление ключом к минимуму.
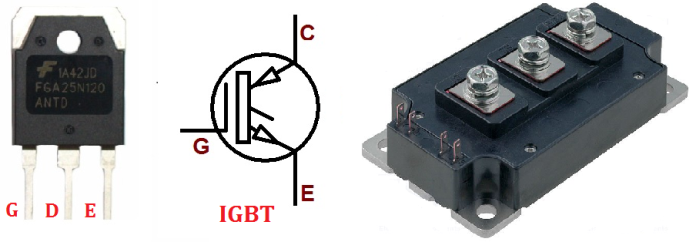
Названия электродов характеризуют структуру IGBT-транзистора: управляющий электрод именуется затвором (как у полевого транзистора), а электроды силового канала — коллектором и эмиттером (как у транзистора биполярного).
Немного истории
Исторически биполярные транзисторы использовались наравне с тиристорами в качестве силовых электронных ключей до 90-х годов. Но недостатки биполярных транзисторов были всегда очевидны: большой ток базы, медленное запирание и от этого перегрев кристалла, сильная зависимость основных параметров от температуры, ограниченное напряжение насыщения коллектор-эмиттер.
Появившиеся позже полевые транзисторы (структуры МОП) сразу изменили ситуацию в лучшую сторону: управление напряжением уже не требует столь больших токов, параметры ключа слабо зависят от температуры, рабочее напряжение транзистора не ограничено снизу, низкое сопротивление силового канала в открытом состоянии расширяет диапазон рабочих токов, частота переключения легко может достигать сотен килогерц, кроме того примечательна способность полевых транзисторов выдерживать сильные динамические нагрузки при высоких рабочих напряжениях.
Поскольку управление полевым транзистором реализуется значительно проще и получается по мощности существенно легче чем биполярным, да к тому же внутри имеется ограничительный диод, – транзисторы с полевым управлением сразу завоевали популярность в схемах импульсных преобразователей напряжения, работающих на высоких частотах, а также в акустических усилителях класса D.

Первый силовой полевой транзистор был разработан Виктором Бачуриным еще в Советском Союзе, в 1973 году, после чего он был исследован под руководством ученого Владимира Дьяконова. Исследования группы Дьяконова относительно ключевых свойств силового полевого транзистора привели к разработке в 1977 году составного транзисторного ключа, внутри которого биполярный транзистор управлялся посредством полевого с изолированным затвором.
Ученые показали эффективность такого подхода, когда токовые свойства силовой части определяются биполярным транзистором, а управляющие параметры — полевым. Причем насыщение биполярного транзистора исключается, а значит и задержка при выключении сокращается. Это – важное достоинство любого силового ключа.
На полупроводниковый прибор нового типа советскими учеными было получено авторское свидетельство №757051 «Побистор». Это была первая структура, содержащая в одном корпусе мощный биполярный транзистор, поверх которого находился управляющий полевой транзистор с изолированным затвором.

Что касается промышленного внедрения, то уже в 1983 году фирмой Intarnational Rectifier был запатентован первый IGBT-транзистор. А спустя два года был разработан IGBT-транзистор с плоской структурой и более высоким рабочим напряжением. Это сделали одновременно в лабораториях двух компаний – General Electric и RCA.
Первые версии биполярных транзисторов с изолированным затвором имели один серьезный недостаток — медленное переключение. Название IGBT было принято в 90-е, когда были созданы уже второе и третье поколение IGBT-транзисторов. Тогда уже этих недостатков не стало.
Отличительные преимущества IGBT-транзисторов

По сравнению с обычными полевыми транзисторами, IGBT-транзисторы обладают более высоким входным сопротивлением и более низким уровнем мощности, которая тратится на управление затвором.
В отличие от биполярных транзисторов — здесь более низкое остаточное напряжение во включенном состоянии. Потери в открытом состоянии, даже при больших рабочих напряжениях и токах, достаточно малы. При этом проводимость как у биполярного транзистора, а управляется ключ напряжением.
Диапазон рабочих напряжений коллектор-эмиттер у большинства широко доступных моделей варьируется от десятков вольт до 1200 и более вольт, при этом токи могут доходить до 1000 и более ампер. Есть сборки на сотни и тысячи вольт по напряжению и на токи в сотни ампер.
Считается, что для рабочих напряжений до 500 вольт лучше подходят полевые транзисторы, а для напряжений более 500 вольт и токов больше 10 ампер — IGBT-транзисторы, так как на более низких напряжениях крайне важно меньшее сопротивление канала в открытом состоянии.
Применение IGBT-транзисторов
Главное применение IGBT-транзисторы находят в инверторах, импульсных преобразователях напряжения и частотных преобразователях (пример — полумостовой модуль SKM 300GB063D, 400А, 600В) — там, где имеют место высокое напряжение и значительные мощности.
Сварочные инверторы — отдельная важная область применения IGBT-транзисторов: большой ток, мощность более 5 кВт и частоты до 50 кГц (IRG4PC50UD – классика жанра, 27А, 600В, до 40 кГц).

Не обойтись без IGBT и на городском электрcтранспорте: с тиристорами тяговые двигатели показывают более низкий КПД чем с IGBT, к тому же с IGBT достигается более плавный ход и хорошее сочетание с системами рекуперативного торможения даже на высоких скоростях.
Нет ничего лучше чем IGBT, когда требуется коммутировать на высоких напряжениях (более 1000 В) или управлять частотно-регулируемым приводом (частоты до 20 кГц).

На некоторых схемах IGBT и MOSFET транзисторы полностью взаимозаменяемы, так как их цоколевка схожа, а принципы управления идентичны. Затворы в том и в другом случае представляют собой емкость до единиц нанофарад, с перезарядкой у удержанием заряда на которой легко справляется драйвер, устанавливаемый на любой подобной схеме, и обеспечивающий адекватное управление.
Любите умные гаджеты и DIY? Станьте специалистом в сфере Internet of Things и создайте сеть умных гаджетов!
Записывайтесь в онлайн-университет от GeekBrains:

Изучить C, механизмы отладки и программирования микроконтроллеров;
Получить опыт работы с реальными проектами, в команде и самостоятельно;
Получить удостоверение и сертификат, подтверждающие полученные знания.
Starter box для первых экспериментов в подарок!
После прохождения курса в вашем портфолио будет: метостанция с функцией часов и встроенной игрой, распределенная сеть устройств, устройства регулирования температуры (ПИД-регулятор), устройство контроля влажности воздуха, система умного полива растений, устройство контроля протечки воды.
Вы получите диплом о профессиональной переподготовке и электронный сертификат, которые можно добавить в портфолио и показать работодателю.
IGBT силовые транзисторы International Rectifier шестого поколения
Известно, что биполярные транзисторы с изолированным затвором (IGBT — Insulated Gate Bipolar Transistor) обладают преимуществами легкого управления полевыми МОП-транзисторами и низкими потерями проводимости, характерными для биполярных транзисторов. На рис. 1 показана эквивалентная схема IGBT-транзистора.

Рис. 1. IGBT можно представить как комбинацию биполярного p_n_p транзистора и MOSFET
Традиционно IGBT используют в тех случаях, где необходимо работать с высокими токами и напряжениями. IGBT-транзисторы в настоящее время выпускают десятки производителей. Среди них — Infineon Technologies, Semikron, International Rectifier, Fairchild Semiconductor, Toshiba, Hitachi, MITSUBISHI, FUJI, IXYS, Power Integration, Dynex Semiconductor и другие.
В конце 1980-х годов было создано первое поколение IGBT-транзисторов, а уже в начале 1990-х появились второе и третье. Прогресс в технологии IGBT шел по линии увеличения рабочих напряжений и токов, а также повышения эффективности преобразования за счет снижения потерь мощности на кристалле как в статическом, так и в динамическом режимах. Происходило и удешевление приборов. К настоящему времени и для серийного производства уже используются технологии четвертого, пятого и шестого поколений IGBT-транзисторов. Следует отметить, что нумерация поколений достаточно условна и у разных фирм может отличаться.
Развитие технологии IGBT-транзисторов фирмой IR
Компания International Rectifier является признанным лидером в разработке и производстве высококачественных силовых полупроводниковых приборов. Диапазон продукции IR достаточно широк и объединяет в себе различные направления. Это и дискретные устройства (биполярные транзисторы с изолированным затвором (IGBT), мощные полевые транзисторы (MOSFET) и модульные сборки на основе кристаллов дискретных элементов, а также ИМС для управления энергосберегающими источниками света, силовые ИМС для электронных балластов люминесцентных ламп и ламп высокого давления, микросхемы драйверов IGBT и MOSFET, включая высоковольтные микросхемы HVIC, продукты на базе интегрированной платформы IMotion и цифровые контроллеры для управления электроприводом, продукты платформы SupIRBuck, микроэлектронные твердотельные реле. В настоящий момент фирма выпускает широкую номенклатуру IGBT, для производства которых используются технологии 4-го (4 PT IGBT), 5-го (5 Non-PT IGBT) и 6-го поколений (DS Trench IGBT). Для первых двух технологий в полевом транзисторе используется планарный затвор, а в последнем (DS Trench) — вертикальный. Собственно, структуры приборов для данных технологий разработаны уже давно и используются производителями на протяжении многих лет. Все дело в нюансах, которые дают возможность производителю реализовать те или иные преимущества технологии. И цена производства кристалла имеет не последнее значение. На рис. 2 показана эволюция технологии IGBT-транзисторов фирмы IR.

Рис. 2. Эволюция технологии IGBT-транзисторов в IR
Новые транзисторы оптимизированы для работы на частотах переключения до 20 кГц, и для снижения энергии потерь на проводимости и переключении в них использована Trench-технология. Эти IGBT с антипараллельным ультрабыстрым диодом имеют энергию переключения ETS и более низкое напряжение насыщения коллектор-эмиттер VCE(on), чем IGBT PT и NPT типа. Кроме того, ультрабыстрый диод с мягким восстановлением дополнительно повышает эффективность преобразования и снижает уровень генерируемых помех.
Технология с вертикальным затвором
Для данного типа технологии затвор полевого транзистора сформирован в виде глубокой канавки (trench gate) на подложке (рис. 2). При изготовлении Trench-FS (Field Stop) транзисторов используется буферный n+ слой в основании подложки. В сочетании с модифицированной конструкцией эмиттера структура затвора позволяет оптимизировать распределение носителей в области подложки и уменьшить напряжение насыщения транзисторов Trench-FS на 30% по сравнению с транзисторами, созданными по технологии NPT. Уменьшается почти на 70% и площадь кристалла, обеспечивается большая плотность тока транзистора.
Технология Trench немного сложнее и дороже, чем NPT. Однако уменьшение размера кристалла Trench-FS снижает его удельную себестоимость, что в итоге позволяет уравнять цены на готовую продукцию по отношению к аналогичным приборам, производимым по другим технологиям. Кроме того, благодаря снижению энергии потерь, при равноценной площади кристалла существенно возрастает ток транзистора (до 60%).
У вертикального затвора, в отличие от пла-нарного, отсутствуют горизонтальные пути протекания тока. Ток течет к коллектору по кратчайшему пути, что обеспечивает снижение потерь на проводимость. Trench IGBT имеют самый низкий уровень статических и динамических потерь среди IGBT, производимых компанией. У новых Trench IGBT благодаря уменьшению длины «хвоста» обеспечивается более плавная траектория переключения, чем у NPT IGBT. «Хвостом» (tail current) называется остаточный ток коллектора биполярного транзистора IGBT, возникающий из-за рассасывания носителей в области базы после запирания транзистора. Благодаря этому энергия выключения стала на 10-20% ниже, чем у NPT IGBT.
Линейка 600 В IGBT-транзисторов Trench 6-го поколения
Семейство 600-вольтовых Trench IGBT в первую очередь ориентировано на использование в UPS-источниках и преобразователях солнечной энергии мощностью до 3 кВт. Силовые приборы этого семейства могут также служить эффективной заменой аналогичных IGBT-транзисторов в системах управления приводом компрессоров в холодильниках, индукционных системах нагрева, а также в приводах мощных вентиляторов. Приборы позволяют на 30% снизить мощность рассеивания по сравнению с IGBT других типов. Компания разработала линейку из 8 приборов в корпусах TO-220TO-247, с рабочим напряжением 600 В и токами 4-48 А.
Для всех типов данных транзисторов используются кристаллы толщиной 70 мкм. Гарантированное время выдержки режима короткого замыкания — не менее 5 мкс для всех типов линейки.
Все корпусированные приборы выполнены по схеме Co-Pack (имеют встроенный антипараллельный ультрабыстрый диод). Основные технические характеристики приведены в таблице 1.
Тип транзистора
Корпус
Imax (25 °С), A
Imax
(100 °C), A
Vce (175 °C), В
Ets (175 °C), мкДж
Rth(j-c), °C/Вт
Мощность, кВт
IGBT транзисторы
 Биполярные транзисторы с изолированным затвором являются новым типом активного прибора, который появился сравнительно недавно. Его входные характеристики подобны входным характеристикам полевого транзистора, а выходные – выходным характеристикам биполярного.
Биполярные транзисторы с изолированным затвором являются новым типом активного прибора, который появился сравнительно недавно. Его входные характеристики подобны входным характеристикам полевого транзистора, а выходные – выходным характеристикам биполярного.
В литературе этот прибор называют IGBT (Insulated Gate Bipolar Transistor) . По быстродействию они значительно превосходят биполярные транзисторы. Чаще всего IGBT-транзисторы используют в качестве мощных ключей, у которых время включения 0,2 – 0,4 мкс, а время выключения 0,2 – 1,5 мкс, коммутируемые напряжения достигают 3,5 кВ, а токи 1200 А.
 IGBT- т ранзисторы вытесняют тиристоры из высоковольтных схем преобразования частоты и позволяют создать импульсные источники вторичного электропитания с качественно лучшими характеристиками. IGBT- т ранзисторы используются достаточно широко в инверторах для управления электродвигателями, в мощных системах бесперебойного питания с напряжениями свыше 1 кВ и токами в сотни ампер. В какой-то степени это является следствием того, что во включенном состоянии при токах в сотни ампер падение напряжения на транзисторе находится в пределах 1,5 – 3,5В.
IGBT- т ранзисторы вытесняют тиристоры из высоковольтных схем преобразования частоты и позволяют создать импульсные источники вторичного электропитания с качественно лучшими характеристиками. IGBT- т ранзисторы используются достаточно широко в инверторах для управления электродвигателями, в мощных системах бесперебойного питания с напряжениями свыше 1 кВ и токами в сотни ампер. В какой-то степени это является следствием того, что во включенном состоянии при токах в сотни ампер падение напряжения на транзисторе находится в пределах 1,5 – 3,5В.
Как видно из структуры IGBT-транзистора (рис. 1), это достаточно сложный прибор, в котором транзистор типа р–n–р управляется МОП-транзистором с каналом типа n.
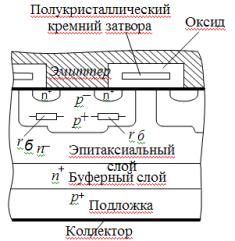
Коллектор IGBT-транзистора (рис. 2,а) является эмиттером транзистора VT4. При подаче положительного напряжения на затвор у транзистора VT1 по-является электропроводный канал. Через него эмиттер транзистора IGBT (коллектор транзистора VT4) оказывается соединенным с базой транзистора VT4.
Это приводит к тому, что он полностью отпирается и падение напряжения между коллектором транзистора IGBT и его эмиттером становится равным падению напряжения на эмиттерном переходе транзистора VT4, просуммированному с падением напряжения Uси на транзисторе VT1.
В связи с тем, что падение напряжения на р–n-переходе уменьшается с увеличением температуры, падение напряжения на отпертом IGBT-транзисторе в определенном диапазоне токов имеет отрицательный температурный коэффициент, который становится положительным при большом токе. Поэтому падение напряжения на IGBT-транзисторе не опускается ниже порогового напряжения диода (эмиттерного перехода VТ4).
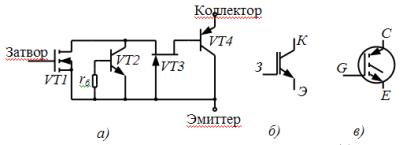
Рис. 2. Эквивалентная схема IGBT-транзистора (а) и его условное обозначение в отечественной (б) и иностранной (в) литературе
При увеличении напряжения, приложенного к транзистору IGBT, увеличивается ток канала, определяющий ток базы транзистора VT4, при этом падение напряжения на IGBT-транзисторе уменьшается.
 При запирании транзистора VT1 ток транзистора VT4 становится малым, что позволяет считать его запертым. Дополнительные слои введены для исключения режимов работы, характерных для тиристоров, когда происходит лавинный пробой. Буферный слой n+ и широкая базовая область n– обеспечивают уменьшение коэффициента усиления по току p–n–p-транзистора.
При запирании транзистора VT1 ток транзистора VT4 становится малым, что позволяет считать его запертым. Дополнительные слои введены для исключения режимов работы, характерных для тиристоров, когда происходит лавинный пробой. Буферный слой n+ и широкая базовая область n– обеспечивают уменьшение коэффициента усиления по току p–n–p-транзистора.
Общая картина включения и выключения достаточно сложная, так как наблюдаются изменения подвижности носителей заряда, коэффициентов передачи тока у имеющихся в структуре p–n–p- и n–p–n-транзисторов, изменения сопротивлений областей и пр. Хотя в принципе IGBT–транзисторы могут быть использованы для работы в линейном режиме, пока в основном их применяют в ключевом режиме.
При этом изменения напряжений у коммутируемого ключа характеризуются кривыми, показанными на рис.3.
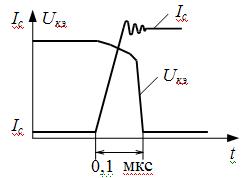

Рис. 4. Схема замещения транзистора типа IGBT (а) и его вольт-амперные характеристики (б)
Исследования показали, что для большинства транзисторов типа IGBT времена включения и выключения не превышают 0,5 – 1,0 мкс. Для уменьшения количества дополнительных внешних компонентов в состав IGBT-транзисторов вводят диоды или выпускают модули, состоящие из нескольких компонентов (рис. 5, а – г).
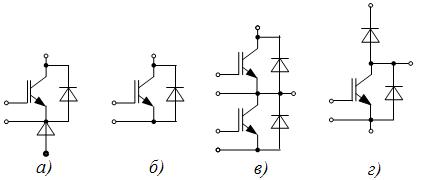
Рис. 5. Условные обозначения модулей на IGBT-транзисторах: а – МТКИД; б – МТКИ; в – М2ТКИ; г – МДТКИ
Условные обозначения IGBT-транзисторов включают: букву М – модуль беспотенциальный (основание изолировано); 2 – количество ключей; буквы ТКИ – биполярный с изолированным затвором; ДТКИ – диод/биполярный транзистор с изолированным затвором; ТКИД – биполярный транзистор с изолированным затвором/диод; цифры: 25, 35, 50, 75, 80, 110, 150 – максимальный ток; цифры: 1, 2, 5, 6, 10, 12 – максимальное напряжение между коллектором и эмиттером Uкэ (*100В). Например модуль МТКИД-75-17 имеет UКЭ =1700 В, I=2*75А, UКЭотк =3,5 В, PKmax =625 Вт.
д.т.н., профессор Л. А. Потапов
Если Вам понравилась эта статья, поделитесь ссылкой на неё в социальных сетях. Это сильно поможет развитию нашего сайта!
Подписывайтесь на наш канал в Telegram!
Просто пройдите по ссылке и подключитесь к каналу.
Не пропустите обновления, подпишитесь на наши соцсети:
IGBT-транзисторы – основные компоненты современной силовой электроники
IGBT-транзистор – гибридный прибор
IGBT-транзисторы или биполярные транзисторы с изолированным затвором (Insulated-Gate Bipolar Transistor) – мощные коммутационные полупроводниковые приборы представляющие собой интегральную структуру, состоящую из входного полевого транзистора и силового биполярного транзистора. Используются в 99,999% как ключевые приборы. По электрическим свойствам представляют собой «грейпфрут» полевого транзистора с изолированным затвором и биполярного транзистора. Управление IGBT-транзистором осуществляется напряжением как полевого транзистора, во включенном состоянии имеют некоторое напряжение насыщения цепи коллектор-эмиттер; сравнительно медленное выключение («токовый хвост», как рудимент, доставшийся в наследство от биполярных транзисторов). Подробнее про внутреннюю структуру IGBT-транзисторов изложено в [Энциклопедия устройств на полевых транзисторах. Дьяконов В.П. и др. СОЛОН-Пресс. 2002. 512 с.]. Первые мощные полевые транзисторы были созданы в СССР.
Практически все выпускаемые IGBT-транзисторы n-канальные. Теоретически существующие p-канальные IGBT-транзисторы по причине невостребованности на рынке отсутствуют.
Ключевыми преимуществами IGBT -транзисторов являются:
– высокие коммутируемые мощности;
– большие значения рабочего напряжения;
– устойчивость к токовым перегрузкам;
– малые мощности управления.
Области использования IGBT-транзисторов:
– в силовых импульсных преобразователях и инверторах (мощностью более 1 кВт);
– в системах индукционного нагрева;
– в системах управления двигателями (частотно-регулируемые привода).
Таким образом, IGBT-транзисторы используются только в качестве ключевых элементов.
Во многих случаях IGBT-транзисторы содержат в своем составе интегрированный быстродействующий обратный диод.
Условное обозначение и внутренняя структура IGBT-транзистора
Условное обозначение и эквивалентная упрощенная внутренняя структура IGBT-транзистора и реальная эквивалентная схема представлены на рисунке ниже.
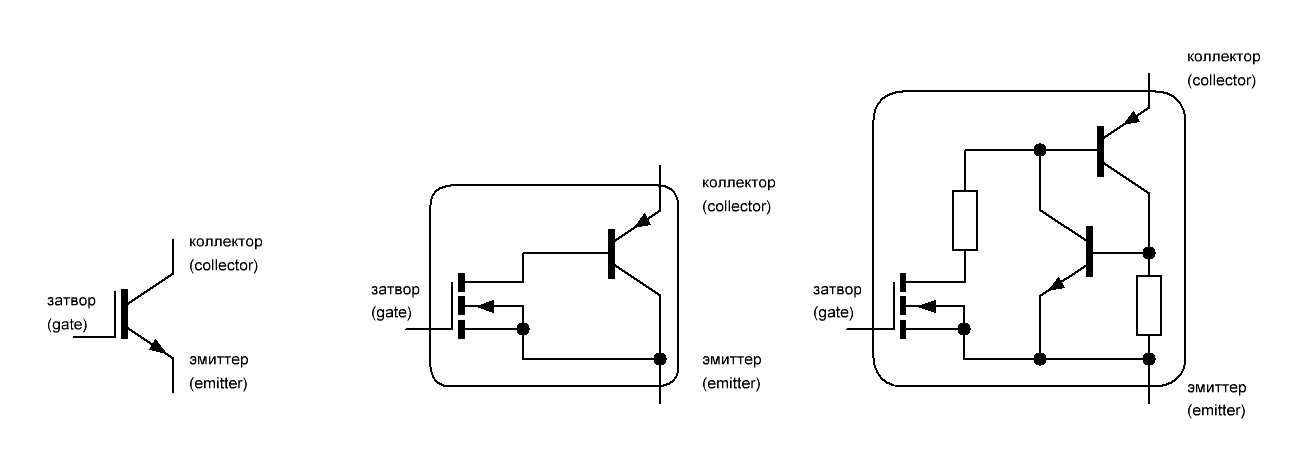
Рисунок IGBT.1 – Условное обозначение и эквивалентная упрощенная внутренняя структура IGBT-транзистора и реальная эквивалентная схема.
В некоторых типах IGBT-транзисторов интегрирован отдельный реверсный быстродействющий диод.
Основные параметры IGBT -транзистора
Ниже перечислены основные параметры IGBT-транзистора, которые приводятся в справочных листках.
1. Максимальное напряжение коллектор-эмиттер (Collector-to-Emitter Voltage или Collector-to-Emitter Breakdown Voltage) VCES – максимально допустимое напряжение между коллектором и эмиттером транзистора.
2. Напряжение насыщения коллектор-эмиттер VCE(on) – падение напряжение между коллектором и эмиттеров в открытом состоянии. При заданном токе коллектора и температуре.
3. Максимальное напряжение затвор-исток (Gate-to-Emitter Voltage) VGE – максимальное управляющее напряжение затвор-эмиттер. При превышении этого напряжения возможен пробой затворного диэлектрика и выход транзистора из строя.
4. Максимальный ток коллектора в непрерывном режиме (Continuous Collector Current) IC – максимальная величина постоянно протекающего тока коллектора. В реальности для IGBT-транзисторов ток существенно зависит от температуры корпуса транзистор и рабочий ток приводится для двух значений температуры 25° С и 100° С.
5. Максимальный импульсный ток через коллектор (Pulsed Collector Current) IСM – максимальная величина импульсного тока через коллектор. Зависит от коэффициента заполнения, условий теплоотвода. Принципиально ограничивается энергией рассеивания кристалла.
6. Пороговое напряжение затвора (Gate Threshold Voltage) VGE(th) – напряжение затвора, при котором транзистор начинает переходить в проводящее состоянии.
7. Температурный коэффициент снижения максимального напряжение коллектор-эмиттер (Temperature Coeff. of Breakdown Voltage) ∆V(BR)CES/∆TJ – коэффициент показывающий снижение максимального напряжение коллектор-эмиттер с увеличением температуры.
8. Температурный коэффициент уменьшения порогового напряжения затвора (TemperatureCoeff. of Threshold Voltage) ∆VGE(th)/∆TJ – коэффициент показывающий снижение порогового напряжения затвора с увеличением температуры.
9.Ток коллектора при нулевом напряжении затвор-эмиттер (Zero Gate Voltage Collector Current) ICES – ток утечки через коллекторный переход при выключенном состоянии транзистора.
10. Прямое падение напряжения на обратном диоде (Diode Forward Voltage Drop) VFM – прямое падение напряжения на интегрированном в конструкцию транзистора быстродейтсвующем обратном диоде.
11. Энергия рассеивания кристалла (Single Pulse Avalanche Energy) EAS – максимальная энергия, которая может быть рассеяна на кристалле транзистора без его разрушения.
12. Максимальная рассеиваемая мощность (Maximum Power Dissipation) PD – максимальная тепловая мощность, которая может быть отведена от корпуса транзистора (при заданной температуре корпуса транзистора).
13. Диапазон рабочих температур – диапазон температур, в пределах которого допускается эксплуатация транзистора.
14. Тепловое сопротивление транзистор-воздух RθJA (Junction-to-Ambient) – максимальное тепловое сопротивление транзистор-воздух (при условии свободного конвективного теплообмена).
15. Тепловое сопротивление кристалл транзистора – корпус транзистора (Junction-to-Case – IGBT) RθJC – максимальное тепловое сопротивление перехода кристалл транзистора – корпус транзистора.
16. Тепловое сопротивление кристалл диода – корпус транзистора (Junction-to-Case – Diode) RθJC– максимальное тепловое сопротивление перехода кристалл интегрированного диода – корпус транзистора.
17. Ток утечки затвора (Gate-to-Emitter Leakage Current) IGES – ток затвора при некотором (как правило, максимальном) напряжении затвор-исток.
18. Общий заряд затвора (Total Gate Charge) Qg – суммарный заряд затвора необходимый для перевода транзистора в проводящее состояние.
19. Заряд затвор-исток (Gate – Emitter Charge) Qge – заряд емкости затвор-эмиттер.
20. Заряд затвор-коллектор (Gate – Collector Charge) Qgc – заряд емкости затвор-коллектор.
21. Время задержки включения (Turn-On Delay Time) td(on) – время за которое транзистор накапливает заряд затвора, при котором транзистор начинает открываться.
22. Время роста тока через транзистор (Rise Time) – время, за которое происходит нарастание тока коллектора транзистора от 10% до 90%.
23. Время задержки выключения (Turn-Off Delay Time) td(off) – время за которое заряд затвора становится меньшим заряда включения, и транзистор начинает закрываться.
24. Время спада тока через транзистор (Fall Time) – время, за которое происходит спад тока коллектора транзистора от 10% до 90%.
25. Потери энергии на включение транзистора (Turn-On Switching Loss) Eon – энергия, выделяемая в кристалле при переходном процессе включения транзистора при заданном напряжении коллектор-эмиттер, напряжении затвора и токе коллектора.
26. Потери энергии на выключение транзистора (Turn-Off Switching Loss) Eoff – энергия, выделяемая в кристалле при переходном процессе выключения транзистора при заданном напряжении коллектор-эмиттер, напряжении затвора и токе коллектора.
27. Суммарные потери энергии на включение-выключение транзистора (Total Switching Loss) Ets– суммарные потери энергии на рабочий цикл включения-выключения транзистора при заданном напряжении коллектор-эмиттер, напряжении затвора и токе коллектора.
28. Максимальная скорость нарастания напряжения исток-сток (dv/dt ruggedness) – максимальная скорость нарастания напряжения исток-сток при которой еще не происходит перехода транзистора в проводящее состояние.
29. Индуктивность вывода стока (Internal Emitter Inductance) LE – паразитная индуктивность вывода эмиттера транзистора.
30. Максимальная скорость обрыва тока при переходе в непроводящее состояние (Diode PeakRate of Fall of Recovery) (di(rec)M/dt) – максимальная скорость обрыва тока через интегрированный диод при переходе в непроводящее состояние под действием смены полярности.
31. Постоянный прямой ток через обратный диод (Continuous Source-Drain Diode Current) IS – максимальное значение постоянно протекающего прямого тока через паразитный p-n диод.
32. Импульсный ток через обратный диод (Pulsed Diode Forward Current) ISM – максимальное значение постоянно протекающего прямого тока через паразитный p-n диод.
33. Падение напряжения на диоде (Body Diode Voltage) VSD – прямое падение напряжения на диоде. При заданных температуре и токе истока.
34. Время восстановления паразитного диода (Body Diode Reverse Recovery Time) trr – время восстановления обратной проводимости паразитного диода.
35. Заряд восстановления паразитного диода (Body Diode Reverse Recovery Charge, Reverse recovery charge) Qrr – заряд, необходимый для восстановления обратной проводимости паразитного диода.
36. Время включения паразитного диода (Forward Turn-On Time) ton – время перехода диода в проводящее состояние. Обычно составляет пренебрежимо малую величину.
37. Входная емкость (Input Capacitance) Cies – сумма емкостей «затвор-коллектор» и «затвор-эмиттер» (при некотором напряжении коллектор-эмиттер).
38. Выходная емкость (Output Capacitance) Coes – сумма емкостей «затвор-коллектор» и «коллектор-эмиттер» (при некотором напряжении коллектор-эмиттер).
39. Проходная емкость (Reverse Transfer Capacitance) Cres – емкость «затвор-коллектор».
Паразитные емкости IGBT-транзистора
Паразитные емкости IGBT-транзистора (рисунок IGBT.2) являются причиной снижения его быстродействия.
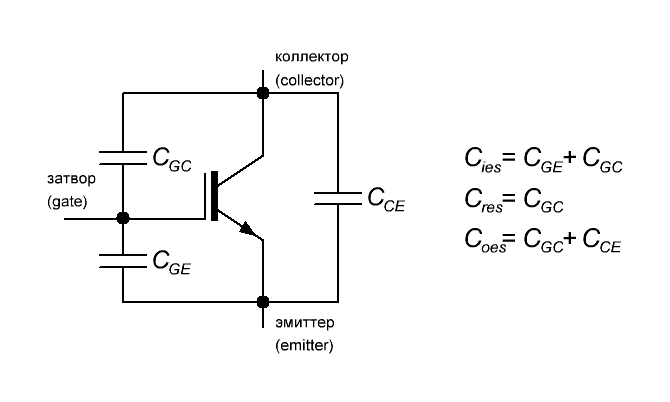
Рисунок IGBT.2 – Паразитные емкости IGBT-транзистора
Классификация IGBT-транзисторов по быстродействию
По скорости переключения IGBT-транзисторы классифицируются на четыре группы как представлено в таблице IGBT.1 :
Таблица IGBT.1 Классификация IGBT-транзисторов по скорости переключения [Мощные и эффективные IGBT седьмого поколения от IR. Донцов Александр. Силовая электроника №5, 2013].
Тип
F, кГц
Ets, мДж
S-Standart (стандарт)
Как видно из таблицы повышение быстродействия (уменьшение потерь на переключение) сопровождается увеличением потерь на проводимость.
По сравнению с MOSFET-транзисторами IGBT-транзисторы имеют меньшую скорость переключения, но большую устойчивость к токовым перегрузкам. Потери на проводимость в MOSFET-транзисторе пропорциональны квадрату тока, а в IGBT-транзисторе пропорциональны току. По этой причине превышение номинальной величины тока критично для MOSFET-транзистора поскольку приводит к катастрофическим потерям и вполне допустимо для IGBT-транзистора. Именно по этой причине IGBT-транзисторы широко используются там, где возможны импульсные токовые перегрузки – сварочные инверторы, системы пуска двигателей и т.д.
IGBT-модули
Поскольку основной областью применения IGBT-транзисторов является мощная преобразовательная техника, то они часто соединяются в IGBT-модули (так называемые «кирпичи»), как правило, имеющие полумостовую топологию. Модули имеют интегрированные обратные диоды, отдельные силовые клеммы и выводы управляющих сигналов затворов.
В общей классификации IGBT-модуль по внутренней электрической схеме может представлять собой (рисунок IGBT.3):
– двойной модуль (half-bridge), где два IGBT соединены последовательно (полумост);
– прерыватели, в которых единичный IGBT последовательно соединён с диодом;
– однофазный или трёхфазный мост.

Рисунок IGBT.3 – IGBT-модули: а – единичный IGBT; б – полумостовой модуль; в, г – сборки с нижним и верхним IGBT; д – мостовой модуль; е – модуль трехфазного моста
MOSFET vs. IGBT. Области применения
Выбор типа ключевого элемента для того или иного преобразователя и стабилизатора является одним из основных вопросов. Ответ на вопрос о том, какой тип приборов MOSFET или IGBT использовать определяется рабочими характеристиками импульсного преобразователя:
Условное разграничение областей применения MOSFET и IGBT представлено на рисунке IGBT.4 [Выбор ключевых транзисторов для преобразователей с жёстким переключением. Александр Полищук. СОВРЕМЕННАЯ ЭЛЕКТРОНИКА. Октябрь 2004. c. 8-11].
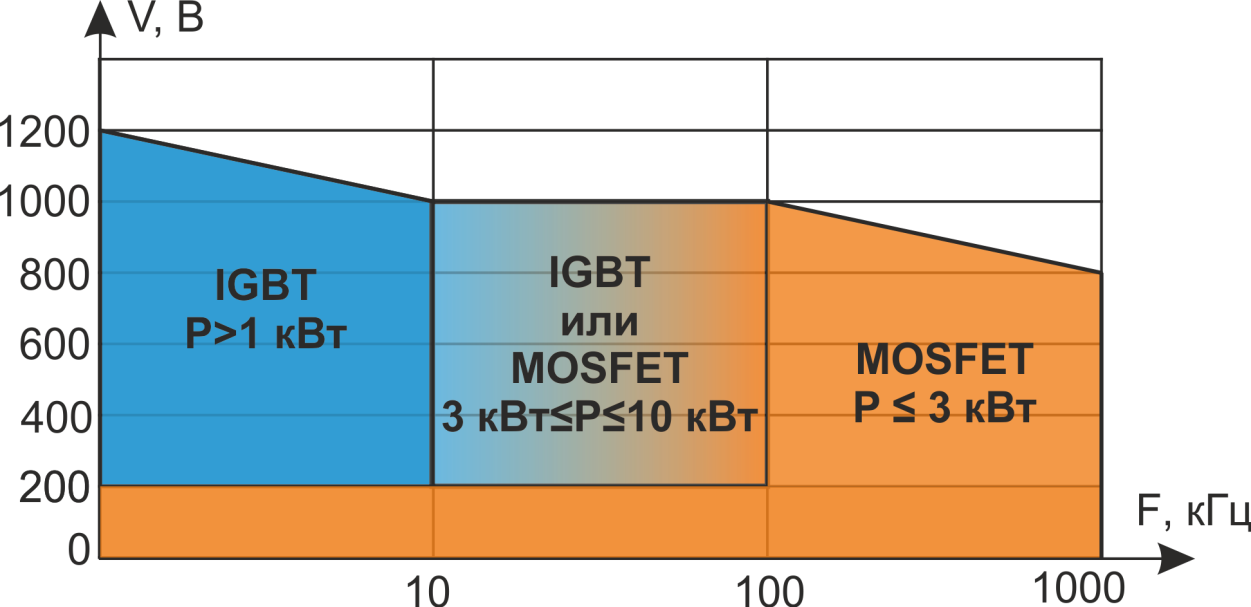
Рисунок IGBT.4 – Условное разграничение областей применения MOSFET и IGBT
Выбор определяют следующие положения:
– с ростом частоты пропорционально возрастают динамические потери на переключение – это существенно для IGBT-транзисторов;
– с ростом мощности статические потери IGBT возрастают пропорционально коммутируемому току, а статические потери в MOSFET возрастают пропорционально квадрату коммутируемого тока;
– с ростом рабочего (максимального) напряжения свыше 1000 В сложно найти MOSFET-транзисторы применение которых было бы экономически целесообразно;
– с ростом частоты снижается коэффициент заполнения.
Транзистор IGBT-принцип работы, структура, основные характеристики
Силовой транзистор IGBT управляется с помощью напряжения, подаваемого на управляемый электрод-«затвор», который изолирован от силовой цепи. Полное название прибора: биполярный транзистор с изолированным затвором.
Характерная черта для этого транзистора – очень малое значение управляющей мощности, использованной для коммутационных операций существенных токовых значений силовых цепей.

Рис. №1. Эффективность использования технологий на основе мощных IGBT-транзисторов
Преобладающее значение приобрело его использование в цепях силового предназначения для частотных преобразователей, для двигателей переменного тока, мощность, которых может доходить до 1 МВт. По своим вольтамперным характеристикам он считается аналогом биполярному транзистору, однако качественные энергетические показатели и чистота коммутационных действий намного выше, чем качество работы других полупроводниковых элементов.
Постоянно совершенствующиеся технологии позволяют улучшить качественные характеристики транзисторов. Созданы элементы, рассчитанные на большую величину напряжения, выше 3 кВ и большие значения тока до нескольких сотен ампер.
Основные характеристики мощных IGBT-транзисторов
- Напряжение управления – это разрешенная проводимость, которая отпирает или запирает прибор.
- Открытое проводящее состояние характеризуется падением напряжения, определяемым пороговым напряжением и внутренним сопротивлением, величина максимально допустимого тока.
Для применения в конструкции регуляторов скорости используются транзисторы, рассчитанные на рабочие частоты в пределах до нескольких десятков килогерц.
Преимущества IGBT транзисторов
- Высокая плотность тока.
- Практически отсутствие потерь статического и динамического типа.
- Отсутствие управляющего тока позволяет не прибегать к использованию гальванически изолированных схем для работы и управления с применением дискретных элементов и предоставляет возможность создания интегральных схем – драйверов.
- Стойкость к воздействию короткого замыкания.
- Относительная простота параллельного соединения.
При разработке схем включения с транзисторами IGBT необходимо обращать внимание на ограничение значения максимального тока. Для этой цели используются следующие методы – это: правильный выбор параметров тока защиты и подбор резистора затвора Rg, а также применение цепей, которые формируют траекторию переключения.
Структура IGBT
Закрытое состояние прибора характеризуется напряжением, приложенным к области n-, она находится между коллектором и эмиттером. Проводящий канал появляется при воздействии на затвор положительно заряженного потенциала в p-области, он обозначается как пунктирная линия. Ток из балласта идет из области n- (с минусом) в область n+. При этом происходит открытие МОП-транзистора, что делает возможным открытие биполярного транзистора с p-n-p перехода транзистора.

Рис. №2. Структура транзистора IGBT.
Эквивалентом структуре транзистора IGBT можно считать схему подключения транзистора, где n-канальный полевой транзистор выполнит роль промежуточного звена (динамического сопротивления), уменьшаемого в открытом состоянии IGBT. Он пропускает через базовую область биполярного транзистора с p-n-p-переходом, при этом происходит уменьшение остаточного напряжения в области n-. Опасность для схемы может представлять так называемый «паразитный биполярный транзистор», он может перейти в открытое состояние, называемое эффектом защелкивания, что влечет потерю управляемости.

Рис. №3. Схема включения транзистора IGBT эквивалентная структуре транзистора.
Применение IGBT-транзистора
Одной из важных сфер использования солового транзистора – это использование в сетях с напряжением 6,5 кВ для создания безопасной и гарантированно надежной работы электроустановок в режиме короткого замыкания.
Для ограничения токов к. з. и приближению их к величине, которая не приведет к повреждениям оборудования. Они выполняют ограничение напряжения на затворе до уровня, не превышающем U = 15,3В. Это достигается с помощью применения следующих мер:
- Ограничение величины напряжения на затворе с помощью привязки к фиксированному уровню напряжения. Это возможно в том случае, если драйвер затвора обладает источником стабильного напряжения. Основной способ -добавление в схему диода с малым падением напряжения, например, диод Шотки. Высокая эффективность меры достигается снижением индуктивности цепи между клеммами источника и затвора.
- Ограничение значения напряжения на затворе с помощью присоединения в цепь между эмиттером и затвором — стабилитрона. Эффективность метода достигается максимально приближенным монтажом диодов к вспомогательным клеммам модуля. Для этой цели должны использоваться диоды с очень маленьким температурным дрейфом и разбросом, примером могут служить диоды ограничивающие переходные напряжения (диоды типа: 1,5КЕ6,8Са и 1,5КЕ7,5СА двунаправленные).
- Включение в схему отрицательной эмиттерной обратной связи. Этот метод возможен после подключения эмиттера драйвера затвора к основным клеммам эмиттера модуля. Эмиттерная связь обратного действия способствует эффективному ограничению напряжения на затворе.
Примеры расчета IGBT-транзистора
Выбор транзистора производится по следующим условиям, например, для преобразователей напряжения с резонансным контуром.
- Транзистор должен переключался при значении нулевого тока.
- Форма токовой синусоиды относительно силовых ключей должна быть аналогична к собственной частоте контура и составляет 100 кГц.
- Амплитуда тока должна соответствовать средней мощности, например, как 40 А к 2000 Вт.
- Определение максимального значения напряжения и максимальной частоты переключения транзисторов при условии, что плечи транзисторов должны работать в противофазе.
Для подбора драйвера IGBT транзистора руководствуются параметрами управления затвора, необходимого для коммутирования отпиранием и запиранием силового полупроводника. Для определения мощности управления нужно знать величину заряда затвора Q gate, частоту коммутации (fin) и реальный замеренный размах напряжения на выходе драйвера ΔVgate

Формула заряда затвора: 
где время интегрирования должно не превышать время на управление выходных напряжений драйвера до их окончательных показателей, или при достижении выходного токового значения драйвера близкого к нулю.
Выбор максимальной величины тока управления затвором определяется по упрощенной формуле:

Зависит от осцилляции величины тока на выходе. Если осцилляция тока управления затвором есть, то значение пикового тока должно быть очень большим, а его величина должна определяться исключительно с помощью измерения.
Не менее важны условия учета размаха выходного напряжения. Наихудший случай – это максимальное значение размаха на затворе, измеряется по реально существующей схеме.
Необходим учет максимальной рабочей температуры, руководствуются значением характерным для условия естественной конверсии без использования принудительного охлаждения.
Максимальная частота коммутации, она должна быть максимально-допустимая. На выбор оказывает влияние результирующая выходная мощность и рассеиваемая мощность резистора, используемого в цепи затвора.
Максимальный ток управления зависит от величины пикового тока, который может протекать через реальный контур управления затвором без появления осцилляций.
Проверка мощных IGBT-транзисторов
Проверка силового транзистора возникает при необходимости ревизии сгоревшего транзистора, например, при ремонте сгоревшего сварочного аппарата или с целью подбора пары для устройства, с тем, чтобы убедится, что это не «перемаркер». Проверку осуществляем с помощью мультиметра: прозваниваем вывода коллектора и эмиттера в обоих направлениях, так мы убедимся в отсутствии короткого замыкания. Входную емкость затвор-эмиттер заряжаем отрицательным напряжением. Осуществляется с помощью кратковременного и одновременного прикосновения щупом «СОМ» мультиметра затвора и щупом от гнезда «V/Ω/f» — эмиттера.

Рис. №4. Проверка транзистора IGBT.
Для проверки необходимо убедиться в рабочей функциональности транзистора. Заряжаем емкость на входе затвор-эмитер положительным напряжением. Это можно сделать, коротко прикоснувшись щупом мультиметра «V/Ω/f» — затвора, к щупу«СОМ» — эмиттера. Проверяем напряжение между коллектором и змиттером, оно должно быть не больше 1,5В, меньшая величина напряжения характерна для низковольтных транзисторов. Если напряжения мультиметра не хватает для открытия и проверки транзистора, входная емкость может заряжаться от источника постоянного напряжения со значением до 15 в.
Пишите комментарии, дополнения к статье, может я что-то пропустил. Загляните на карту сайта, буду рад если вы найдете на моем сайте еще что-нибудь полезное.
IGBT транзисторы для силовых преобразователей
Ранее мы называли транзисторы MOSFET почти идеальными приборами для использования в изделиях силовой электроники. Сейчас настало время повторить одну существенную оговорку, также сделанную нами выше: справедливость слов об идеальности транзисторов MOSFET не ставится под сомнение, если рабочее напряжение силовых цепей преобразователей не превышает 250…300 (максимум — 400) В. При дальнейшем повышении рабочего напряжения приходится выбирать транзисторы с более высокой величиной напряжения «сток-исток», а это означает, что нам будет затруднительно найти в номенклатуре серийно выпускаемых приборов такой типономинал, который при высоких допустимых напряжениях «сток—исток» будет иметь низкое сопротивление канала в открытом состоянии, и, соответственно, высокий ток стока. Максимальная величина допустимого напряжения «сток—исток» большинства серийных транзисторов MOSFET сегодня составляет порядка 800 В, но сопротивление канала в открытом состоянии у них измеряется уже единицами Ом. Справедливости ради отметим, что иногда все-таки можно встретить приборы с допустимым напряжением «сток—исток» порядка 1000… 1200 В, но это — опять же «штучный товар», не находящий практического применения, а потому потихоньку исчезающий с рынка силовых полупроводников. Как же поступить разработчику в случае разработки высоковольтного мощного статического преобразователя? Опять возвращаться к биполярным транзисторам? Ни в коем случае!
Оказывается, на этапе изготовления транзистора возможно объединить такие преимущества биполярных приборов, как большая допускаемая величина напряжения «коллектор—эмиттер», и полевых транзисторов — как минимальные затраты энергии на управление. Объединение этих замечательных свойств происходит благодаря специально разработанным технологическим приемам, в результате чего получается биполярный транзистор с изолированным затвором. Ведущие мировые фирмы разработали множество технологических приемов получения таких транзисторов, с различными внутренними струк-
турами, однако на сегодняшний день наибольшее распространение получили комбинированные транзисторы эпитаксильной структуры PT (punchthrough) и однородной структуры NPT (nonpunch-through). Сегодня данные транзисторы объединены общим наименованием IGBT (insulated gate bipolar transistor), произносящимся на слух как «ай-джи-би-ти» (рис. 2.1.29). Именно в структуре типа IGBT наиболее удачным образом удалось соединить положительные свойства чистых полевых и биполярных приборов, работающих в ключевом режиме.

Давайте вспомним, что на этапе производства полевыхтранзисторов MOSFET в их структуре обязательно появляется паразитный биполярный транзистор, который не находит практического применения, а зачастую просто ухудшает положительные динамические свойства полевого транзистора. Проведенные исследования показали, что возможно ввести в структуру транзистора несколько новых элементов, благодаря которым он превратится в совершенно новый прибор с уникальными свойствами, а паразитный элемент как бы исчезнет во внутренней структуре и не будет влиять на динамические процессы, протекающие в силовой цепи. На рис. 2.1.30 условно показано внутреннее устройство IGBT транзистора, причем на рис. 2.1.30, а приведены все «технологические» элементы, появляющиеся на этапе изготовления. Здесь мы видим знакомый нам входной транзистор типа MOSFET VT1, цепь «сток-исток» которого зашунтирована паразитным биполярным р-п-р-транзистором VT3 с резистором Rb в его собственной цепи «база—эмиттер». Новые элементы — биполярный транзистор структуры n-p-n VT2 и полевой транзистор с управляющим р-п-переходом VT4. Последний транзистор выполняет роль динамического сопротивления, которое уменьшается во включенном состоянии и пропускает ток через базовую область транзистора VT2.

Первый шаг к упрощению эквивалентной схемы IGBT транзистора сделан на рис. 2.1.30, б, где транзистор VT4 заменен условным резистором с переменным сопротивлением Rmod. Теперь, взглянув на схему, можно увидеть, что образовавшаяся структура из биполярных транзисторов VT2 и VT3 может иметь положительную обратную связь, так как ток коллектора VT2 самым непосредственным образом влияет на ток базы VT3, и наоборот. Вообще данная структура сильно напоминает 4-х слойную тиристорную структуру, а значит, возможно появление неприятного эффекта защелкивания этой р-п-р-п-структуры, что часто наблюдалось в первых образцах IGBT приборов. К чему может привести защелкивание, долго объяснять не нужно — транзистор теряет управление в открытом состоянии, и силовая схема может просто выйти из строя.
Исследованию эффекта защелкивания 4-х слойных структур IGBT транзисторов было посвящено множество научных работ, и сегодня этот весьма неприятный эффект, благодаря развитию технологий производства, можно считать ушедшим в историю данных приборов. Производители научились с ним успешно бороться, управляя величиной Rb и Rmod, а также коэффициентами усиления VT2 и VT3 на стадии изготовления. Исследования также показали, что устойчивость 4-х слойных структур к защелкиванию снижается при увеличении скорости изменения напряжения «коллектор—эмиттер» в единицу времени, то есть защелкивание проявляется в моменты коммутации ключей в силовой схеме, а значит, можно принять меры по ограничению скорости нарастания токов. Добавим, что ведущие мировые фирмы-производители транзисторов IGBT («International Rectifier», «IXYS», «Motorola», «Intersil», «Semikron», «Mitsubishi», «Eupec», «Dynex» и др.) гарантируют отсутствие «защелкивания» биполярных структур, поэтому в их технической документации часто приводится упрощенная эквивалентная схема IGBT приборов, показанная на рис. 2.1.30, в.
На рис. 2.1.31 представлен разрез внутренней структуры типового IGBT прибора. Биполярный транзистор образуется здесь слоями р + (эмиттер), n (база), p (коллектор), а полевой транзистор — слоями полупроводника n (исток), п + (сток) и металлической пластиной (затвор). Полупроводниковые слои р + и p имеют внешние выводы, с помощью которых транзистор подключается к электронной схеме.
Для разработки статических преобразователей электроэнергии на основе транзисторов IGBT нет необходимости подробно знакомиться с параметрами составных элементов полупроводникового прибора. Достаточно представить IGBT прибор в виде обычного трехэлектродного элемента, имеющего типовые параметры и характеристики, которые можно получить из технической документации конкретного типономинала. Именно поэтому мы более не будем останавливаться на рассмотрении различных внутренних структур IGBT приборов, а пе-

Рис. 2.1.31. Внутренняя структура IGBT транзистора
рейдем к вопросам практического использования этих транзисторов в устройствах преобразовательной техники.
В первую очередь разработчика устройств силовой электроники должен интересовать следующий вопрос: «Какое положение по быстродействию, то есть скорости включения и выключения, занимает транзистор IGBT по сравнению с транзисторами MOSFET и классическими биполярными транзисторами?» Однозначно можно сказать, что транзистор MOSFET переключается быстрее транзистора IGBT, но в случае сравнения с биполярным транзистором нельзя сделать утвердительный вывод в пользу того или иного прибора, и вот почему.
Ограничение скорости переключения биполярных транзисторов с изолированным затвором, как и простых биполярных транзисторов, определяется конечным временем жизни неосновных носителей в их базовых областях. Если включение транзисторов происходит достаточно быстро, то необходимость выделения некоторого времени на рассасывание неосновных носителей в базовой области замедляет процесс восстановления их непроводящего состояния (выключения). Для IGBT, процесс выключения которого в целом похож на аналогичный процесс для транзистора типа MOSFET, значительная задержка выключения связана с так называемым «токовым хвостом», когда остаточный ток коллектора продолжает совершать колебательные движения, приближаясь к нулевому значению. Причина «токового хвоста» кроется в накоплении заряда базовой областью и его постепенном рассасывании при окончательном переходе внутреннего MOSFET в режим отсечки. Чем опасен «токовый хвост»? Тем, что он ведет к увеличению тепловых потерь и требует увеличения так называемого «мертвого времени» (dead time) для полумостовых и мостовых силовых схем в промежутках между фазами проводимости ключевых элементов.
Фирмы-производители элементной базы сделали немало усилий для оптимизации процессов рассасывания неосновных носителей в базовой области IGBT приборов, однако эта задача оказалась настолько противоречивой по воздействующим факторам, что решать ее пришлось комплексно, то есть не только улучшать технологию производства, но и применять схемотехнические ухищрения. Конечно, производители элементной базы могли бы оставить разработчикам преобразовательной техники возможность управления процессами рассасывания неосновных носителей, если бы вывели наружу базу внутреннего биполярного транзистора VT2. Но этот путь снизил бы потребительские качества транзисторов: слишком сложно тогда бьшо бы применять их в конкретных схемах. К тому же, как оказалось, выигрыш от такого решения не столь значителен, поэтому этот базовый вывод традиционно делают недоступным извне. Кроме этого, удалось выработать особые технологические приемы, позволяющие ускорить процесс рекомбинации носителей базовой области, среди которых — снижение коэффициента усиления транзистора VT2.
К сожалению, в процессе оптимизации переключающих свойств IGBT приборов возникло еще одно существенное противоречие: снижение коэффициента усиления в значительной степени уменьшает «токовый хвост», но увеличивает напряжение насыщения открытого транзистора, а значит, и статические потери в открытом состоянии (потери проводимости). Увеличение коэффициента усиления, наоборот, снижает напряжение насыщения, но приводит к росту «токового хвоста», а значит, и к росту потерь переключения (динамических потерь). Чрезмерное же увеличение коэффициента может привести к резкому повышению вероятности возникновения защелкивания. До некоторой степени с опасным эффектом удается бороться, варьируя сопротивления Rb и Rmod. Но перечисленные проблемы интересуют только производителей, а разработчикам преобразовательной техники важны только результаты их решения.
Источник: Семенов Б. Ю. Силовая электроника: профессиональные решения. — М.: СОЛОН-ПРЕСС, 2011. — 416 c.: ил.
IGBT транзисторы. Устройство и работа. Параметры и применение
В настоящее время в электронике имеют большую популярность IGBT транзисторы. Если расшифровать эту аббревиатуру с английского языка, то это биполярный транзистор с изолированным затвором. Он применяется в виде электронного мощного ключа для систем управления приводами механизмов, в источниках питания.
IGBT транзисторы
Этот силовой транзистор сочетает в себе свойства биполярного и полевого транзистора. Он управляется путем подачи напряжения на затвор, изолированный от цепи. Характерным свойством этого транзистора является низкая величина мощности управления, которая применяется для переключений мощных силовых цепей.
Наибольшей популярностью пользуются IGBT в силовых цепях преобразователей частоты и электродвигателей переменного тока мощностью до 1 мегаватта. По вольтамперным свойствам эти транзисторы аналогичны биполярным моделям полупроводников, но качество и чистота коммутации у них намного больше.
Современные технологии изготовления дают возможность оптимизировать транзисторы по функциональным характеристикам. Уже разработаны полупроводники, способные работать при большем напряжении и величине тока.
Основные параметры
- Управляющее напряжение – это разность потенциалов, способная управлять работой затвора.
- Наибольший допустимый ток.
- Напряжение пробоя между эмиттером и коллектором.
- Ток отсечки эмиттер-коллектор.
- Напряжение насыщения эмиттер-коллектор.
- Входная емкость.
- Выходная емкость.
- Паразитная индуктивность.
- Период задержки подключения.
- Период задержки выключения.
- Внутреннее сопротивление.
В регуляторах скорости применяются IGBT транзисторы с рабочей частотой в несколько десятков кГц.
Достоинства
- Простая параллельная схема.
- Отсутствие потерь.
- Повышенная плотность тока.
- Устойчивость к замыканиям.
- Малые потери в открытом виде.
- Возможность функционирования при повышенной температуре (выше 100 градусов).
- Эксплуатация с высоким напряжением (выше 1 кВ) и мощностями (более 5 кВт).
При проектировании схем подключения с транзисторами нужно иметь ввиду, что существует ограничение по наибольшему току. Для этого применяют некоторые способы:
- Правильный подбор тока защиты.
- Выбор сопротивления затвора.
- Использование обходных путей коммутации.
Устройство и работа
Внутреннее устройство IGBT транзисторов включает в себя каскад двух электронных ключей, управляющих конечным выходом.
Принцип действия транзистора заключается в двух этапах:
- При подаче напряжения положительного потенциала между истоком и затвором полевой транзистор открывается, появляется n-канал между стоком и истоком.
- Начинается движение заряженных электронов из n-области в р-область, вследствие чего открывается биполярный транзистор. В результате этого от эмиттера к коллектору протекает электрический ток.
IGBT транзисторы служат для приближения токов замыкания к безопасному значению. Они ограничивают напряжение затвора следующими методами:
- С помощью привязки к определенному значению напряжения. Это достигается тогда, когда драйвер затвора имеет постоянное напряжение. Главным способом является добавление в схему диода, имеющего малое падение напряжения (диод Шоттки). Значительный эффект получается путем уменьшения индуктивности цепи затвора и питания.
- Ограничение значения напряжения затвора путем использования стабилитрона в схеме затвора и эмиттера. Неплохая эффективность получается за счет установки диодов к дополнительным клеммам модуля. Диоды применяются с малым разбросом и температурной зависимостью.
- Подключение в цепь отрицательной обратной связи эмиттера. Такой способ доступен, когда подключен эмиттер драйвера затвора к клеммам эмиттера модуля.
Сфера использования
IGBT транзисторы чаще всего работают в сетях высокого напряжения до 6,5 киловольт для надежной и безопасной работы электроустановок в аварийном режиме при коротких замыканиях.
Вышеперечисленные свойства транзисторов дают возможность использовать их в частотно-регулируемых приводах, инверторах, импульсных регуляторах тока, а также в сварочных аппаратах.
Также IGBT применяются в системах мощных приводов управления электровозов, троллейбусов. Это повышает КПД и создает повышенную плавность хода.
Силовые транзисторы широко используются в цепях высокого напряжения. Они входят в состав схем посудомоечных машин, бытовых кондиционеров, автомобильного зажигания, блоков питания телекоммуникационного оборудования.
Проверка исправности
IGBT транзисторы проверяются в случаях ревизии при неисправностях электрического устройства. Проверку проводят с помощью мультитестера путем прозвонки электродов эмиттера и коллектора в двух направлениях, чтобы проверить отсутствие замыкания. Емкость входа эмиттер-затвор необходимо зарядить отрицательным напряжением. Это делается кратковременным касанием щупа мультиметра «СОМ» затвора и щупа «V/Ω/f» эмиттера.

Чтобы произвести проверку, нужно убедиться, работает ли в нормальном режиме транзистор. Для этого зарядим емкость на входе эмиттер-затвор положительным полюсом. Это делается коротким касанием щупа «V/Ω/f» затвора, а щупа «СОМ» эмиттера. Контролируется разность потенциалов эмиттера и коллектора, которая не должна превышать 1,5 вольта. Если напряжения тестера не хватит для открывания транзистора, то входную емкость можно зарядить от питания напряжением до 15 вольт.
Условное обозначение
Транзисторы имеют комбинированную структуру, то и обозначения у них соответствующие:

IGBT модули
Силовые транзисторы производятся не только в виде отдельных полупроводников, но и в виде модулей. Такие модули входят в состав частотных преобразователей для управления электромоторами.

Схема преобразователя частоты имеет технологичность изготовления выше, если в состав входят модули IGBT транзисторов. На изображенном модуле выполнен мост из двух силовых транзисторов.
IGBT транзисторы нормально функционируют при рабочей частоте до 50 кГц. Если частоту повышать, то повышаются и потери. Свои возможности силовые транзисторы проявляют максимально при напряжении выше 400 В. Поэтому такие транзисторы часто встречаются в мощных электрических приборах высокого напряжения, а также в промышленном оборудовании.
Из истории возникновения
Полевые транзисторы стали появляться в 1973 году. Затем разработали составной транзистор, который оснастили управляемым транзистором с помощью полевого полупроводника с затвором.
Первые силовые транзисторы имели недостатки, выражавшиеся в медленном переключении, низкой надежностью. После 90 годов и по настоящее время эти недостатки устранены. Силовые полупроводники имеют повышенное входное сопротивление, малый уровень управляющей мощности, малый показатель остаточного напряжения.
Сейчас существуют модели транзисторов, способных коммутировать ток до нескольких сотен ампер, с рабочим напряжением в тысячи вольт.








